Welcome to
System Integration & Reliable Interconnects
Lab
International College of Semiconductor Technology,
National Yang Ming Chiao Tung University
About
At the System Integration & Reliable Interconnects (SIRI) Lab at NYCU we specialize in power semiconductor packaging technologies, primarily GaN and SiC-based devices. The balance between high performance and power efficiency in the ever-scaling semiconductor industry has demanded new materials beyond Silicon to compensate for large power and temperature needs. Wide-bandgap semiconductors continue to revolutionize power electronics due to their superior electrical and thermal properties. As such, our research aims to develop high-reliability packaging solutions that maximize their performance.
Our lab is not only aimed at creating the next generation of power device packaging technology but also equipping students with the technical skills and bigger-picture thinking to develop high-efficiency and high-power-density devices. As part of SIRI Lab, you will have the chance to work with state-of-the-art fabrication and packaging tools such as sputtering and evaporation systems for thin-film deposition, thermal imaging for in situ temperature characterization, wire bonders, die bonders, and thermocompression bonders. You can be confident that our researchers become competent in important skills such as device fabrication, process integration, and reliability assessment. With opportunities to publish in high-impact journals, present at international conferences, and collaborate with industry leaders, our students are well-prepared for careers in both academia and the semiconductor industry. We welcome motivated students with backgrounds in materials science, electrical engineering, or mechanical engineering, who are eager to advance power semiconductor packaging technology.


Pioneering Minds Unite
Prof. Chen, Prof Iwai, Prof. Sun and Prof Kuan, members of AI power supply project team meet NSTC Minister 吳誠文 at the Chip Innovation project expo.

Prof. Chen and other members of the Chip-Innovation project(晶創計畫) meet semiconductor legend Chenming Hu(胡正明院士), TSMC's first Chief Technology Officer, at the National Science and Technology Council.
Student Accomplishments
Many of our students have received prestigious scholarships:
- 黃子庭 and 林群恩 awarded the NSTC-DAAD scholarship for internship at Fraunhofer IZM
- Dao Minh Anh awarded the Elite Ph.D. scholarship from NYCU
- Polina Leger awarded the MOE Chip-Driven Advanced IC Design Scholarship

Tools
- Semiconductor Measurement System
- Cryo Chamber
- Testbench for thermal imaging and power cycling
- Sputtering
- Thermal Compression Bonder
- Metallography System
- Shear Tester

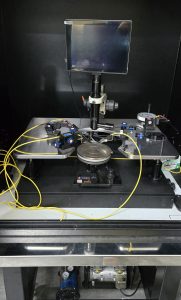
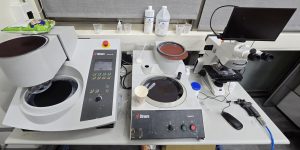

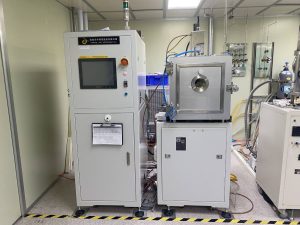

Specializations
Key areas of investigation include thermal management strategies, Ag sintering technology, nanotwinned film applications, and ultrasonic bonding techniques for Al; Al/Cu; and Cu heavy wire interconnects.
By integrating advanced materials and interconnect technologies, we confront the critical challenges of high-power and high-temperature operation in SiC and GaN devices.
Click the link to learn more about the research topics in our lab









